

AEC-Q104测试服务
AEC-Q104测试能力提供全套的测试认证服务,通过使用各种测试分析技术和分析程序确认产品的失效现象,分辨其失效模式或机理,确定其最终原因,提出改进设计和制造工艺的建议,来消除失效并防止失效的再次发生,提高产品的可靠性。
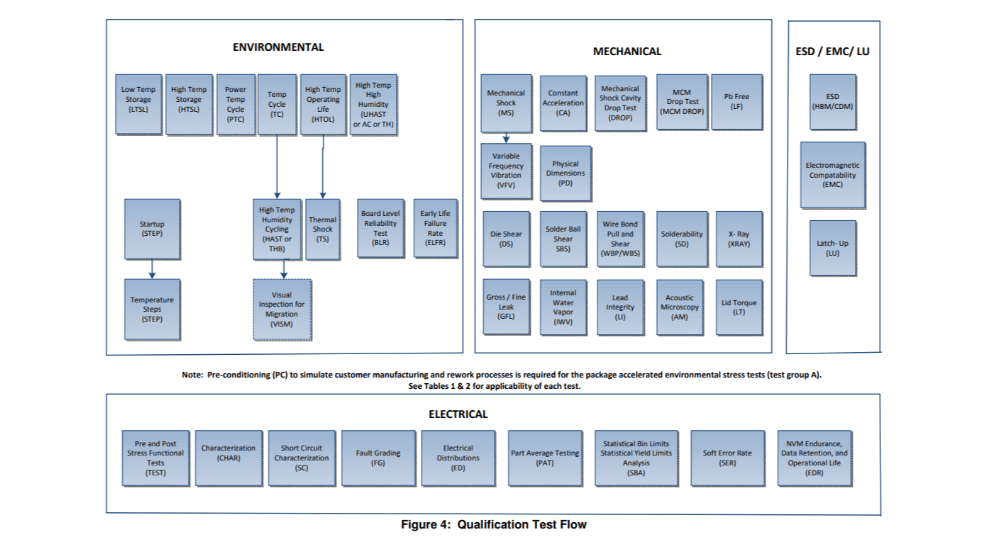
AEC-Q104是基于失效机制的车用多芯片组件(MCM)应力测试认证规范。MCM多芯片模组规范解决了困扰IC设计厂商与Tier1汽车模块商在MCM、系统构装(System In Package, SIP)、堆叠式封装(Stacked Chip)等复杂多芯片型态应该依循IC,还是模块规范的难题。更是在车用行业规范中,首次定义车用板阶可靠性测试项目(Board Level Reliability,BLR)的规范。
| 序号 | 测试项目 | 缩写 | 检测方法 |
| A 组 加速环境应力测试 | |||
| A1 | 预处理 | PC | J-STD-020; JESD22-A113 |
| A2 | 有偏温湿度或有偏高加速应力测试 | THB/HAST | JESD22-A101; JESD22-A110 |
| A3 | 高压或无偏高加速应力测试或无偏温湿度测试 | AC/ UHST/TH | JESD22-A102; JESD22-A118; JESD22-A101 |
| A4 | 温度循环 | TC | JESD22-A104 |
| A5 | 功率负载温度循环 | PTC | JESD22-A105 |
| A6 | 高温储存寿命测试 | HTSL | JESD22-A103 |
| B 组 加速寿命模拟测试 | |||
| B1 | 高温工作寿命 | HTOL | JEDEC JESD22-A108 |
| B2 | 早期寿命失效率 | ELFR | 附录 2 |
| B3 | NVM 写次数、数据保持和工作寿命 | EDR | AEC Q100-005 |
| C 组 封装组合完整性测试 | |||
| C1 | 焊线剪切 | WSS | AEC-Q100-001; AEC-Q003 |
| C2 | 焊线拉力 | WBP | MIL-STD-883 Method2011; AEC-Q003 |
| C3 | 可焊性 | SD | JESD22; J-STD-002 |
| C4 | 物理尺寸 | PD | JESD22-B100; JESD22-B108 |
| C5 | 键球剪切 | SBS | JESD22-B117 |
| C6 | 引脚完整性 | LI | JESD22-B105 |
| C7 | X-RAY | X-RAY | / |
| C8 | 声学显微镜 | AM | / |
| D 组 芯片晶圆可靠度测试 | |||
| D1 | 电迁移 | EM | JEDEC JEP001 |
| D2 | 经时介质击穿 | TDDB | JEDEC JEP001 |
| D3 | 热载流子注入效应 | HCI | JEDEC JEP001 |
| D4 | 负偏压温度不稳定性 | NBTI | JEDEC JEP001 |
| D5 | 应力迁移 | SM | JEDEC JEP001 |
| E 组 电气特性确认测试 | |||
| E1 | 应力测试前后功能参数测试 | TEST | 规格书 |
| E2 | 静电放电 (HBM) | HBM | AEC-Q100-002; ANSI/ESDA/JEDEC JS-001 |
| E3 | 静电放电 (CDM) | CDM | AEC-Q100-011; ANSI/ESDA/JEDEC JS-002 |
| E4 | 闩锁效应 | LU | AEC-Q100-004; JESD78 |
| E5 | 电分配 | ED | AEC-Q100-009 |
| E6 | 故障等级 | FG | AEC-Q100-007 |
| E7 | 特性描述 | CHAR | AEC-Q003 |
| E8 | 电磁兼容 | EMC | SAE J1752/3 RE |
| E9 | 软误差率 | SER | JESD89-1; JESD89-2; JESD89-3 |
| E10 | 无铅 (Pb) | LF | AEC-Q005 |
| F 组 缺陷筛选测试 | |||
| F1 | 过程平均测试 | PAT | AEC-Q001 |
| F2 | 统计良率分析 | SBA | AEC-Q002 |
| G 组 腔体封装完整性测试 | |||
| G1 | 机械冲击 | MS | JESD22-B110 |
| G2 | 变频振动 | VFV | JESD22-B103 |
| G3 | 恒加速 | CA | MIL-STD-883; Method2001 |
| G4 | 粗细气泡测试 | GFL | MIL-STD-883; Method1014 |
| G5 | 跌落 | DROP | JESD22-B110 |
| G6 | 弯曲扭力测试 | LT | MIL-STD-883; Method2024 |
| G7 | 芯片剪切 | DS | MIL-STD-883; Method2019 |
| G8 | 内部水汽含量测试 | IWV | MIL-STD-883; Method1018 |
| H 组 额外特殊要求 | |||
| H1 | 振动可靠性 | VLR | PC-9701 |
| H2 | 低温储存寿命测试 | LTSL | JESD22-A119 |
| H3 | 振动和温度冲击 | STEP | ISO 16750-4 |
| H4 | 跌落 | DROP | JESD22-B111 |
| H5 | 破坏性物理分析 | DPA | MIL-STD-158 |
| H6 | X-RAY | X-RAY | / |
| H7 | 声学显微镜 | AM | / |
